|
Здравствуйте Владимир (Ефименко). Я обучаюсь по программе повышения квалификации "Наноэлектронная элементная база информатики на основе полупроводников и ферромагнетиков". У меня проблема с тестом № 2 (к лекции № 2) по этой программе. Я несколько раз пытался пройти этот тест, но больше 50 баллов набрать не удаётся, хотя я всё делаю в соответствии сматериалом лекции. В заданиях этого теста есть ошибки, которые видны невооружённым глазом. Обращаюсь к Вам как к инспектору этой программы повышения квалификации. Найдите возможность исправить ошибки в тесте № 2. Из-за остановки на этом тесте я не могу двигаться дальше, а у меня очень ограниченное время на освоение этой программы. Заранее благодарен Вам за внимание к моим проблемам и помощь. |
Память c иcпользованием СТП и спинтронные логические схемы
Память с использованием СТП
Второе поколение магниторезистивной памяти
Для улучшения характеристик магниторезистивных ОЗУ запись информации методом спин-транспортного перемагничивания (СТП) выгодней комбинировать с вертикальным намагничиванием ферромагнитных слоев. Структура ячейки памяти (МРОЗУ) с вертикальным намагничиванием и с записью информации методом СТП показана на рис. 2.1. Пусть сначала "свободный" (запоминающий) ферромагнитный элемент (СФЭ) намагничен вниз, и электрическое сопротивление магниторезистивной ячейки велико (состояние "1"). Если сквозь ячейку пропустить электрический ток Із0, превышающий критическую величину ІК0 ( рис. 2.1.a), то электроны, выходящие из "фиксированного" ферромагнитного элемента (ФФЭ), переносят вверх магнитный момент, ориентированный вверх. И СФЭ перемагничивается в состояние "0". При достаточной силе тока это может произойти за время порядка 1 нс. Достигнуто и рекордное время СТП 100 пс. Если ток Із0 пропускать сквозь ячейку в состоянии "0", то состояние ячейки не изменится, так как магнитные моменты в СФЭ уже ориентированы вверх.
Для записи "1" в ячейку, которая находится в состоянии "0", сквозь нее пропускают ток Із1 (рис. 2.1.б). Электроны, которые в этом случае выходят из электрода Эл1, имеют магнитные моменты, ориентированные как вверх, так и вниз. Электроны с магнитным моментом, ориентированным вверх, легко проходят сквозь туннельный переход (ТП), а электроны с магнитным моментом, ориентированным вниз, накапливаются. И если их концентрация становится достаточной, ВФЭ перемагничивается в состояние "1". Пропускание тока записи "1" (Із1) сквозь ячейку, которая уже находится в состоянии "1", не изменяет состояние ячейки.
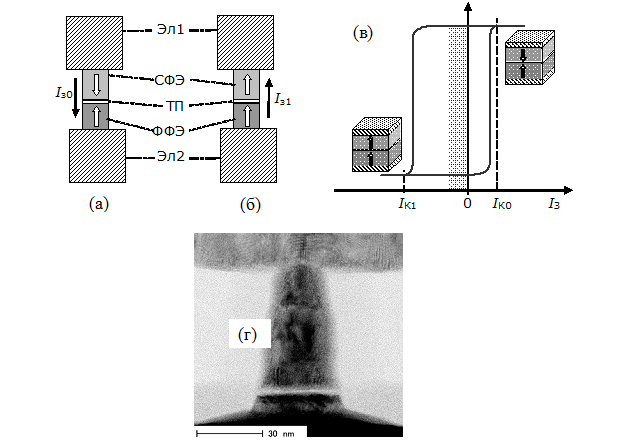
Рис. 2.1. . Структура ячейки памяти МРОЗУ 2-го поколения. (а) Запись "0" и (б) запись "1" методом СТП; (в) зависимость электрического сопротивления магниторезистивной ячейки от величины тока сквозь нее; (г) поперечный срез магниторезистивной запоминающей ячейки (снимок в АСМ)
На рис. 2.1.в показана зависимость электрического сопротивления магниторезистивной ячейки от величины пропускаемого сквозь нее электрического тока. Зависимость эта асимметрична потому, что для перемагничивания в состояние "1" используются электроны с ориентированным вверх магнитным моментом, которые составляют большинство в ФФЭ, а для перемагничивания в состояние "0" используются электроны с ориентированным вниз магнитным моментом, которые составляют меньшинство в СФЭ. Поэтому критический ток ІК1 перемагничивания в состояние "1" в несколько раз больше, чем критический ток ІК0 перемагничивания в состояние "0".
На рис. 2.1.г показана нанофотография в атомном силовом микроскопе поперечного среза ячейки современной магниторезистивной памяти с вертикальной намагниченностью и записью информации методом СТП.
Критический ток, требуемый для перемагничивания методом СТП, быстро уменьшается с уменьшением размеров ячейки. Уже при размерах ячейки меньше 300 нм он становится меньше электрического тока, который надо подавать в адресную и разрядную шины для перемагничивания запоминающего элемента суммарным магнитным полем указанных токов. Поэтому МРОЗУ стали первыми промышленными изделиями, в которых уже широко используют метод СТП.
На рис. 2.1.в серым прямоугольником выделена область тех значений тока, которые используют для считывания информации из ячейки памяти. Это – совсем малые токи, достаточные для определения того, большое или малое сопротивление имеет ячейка, но явно недостаточные для ее перемагничивания.
Переход к вертикальной намагниченности и к записи информации методом СТП позволил значительно уменьшить площадь отдельных ячеек памяти и соответственно увеличить объем информации в одном кристалле (чипе); благодаря возможности параллельной записи слова значительно сократить время записи, а также уменьшить затраты энергии на запись до величины порядка 1 пДж/бит.
МРОЗУ с записью информации методом СТП считают "2-м поколением" магниторезистивной памяти. В англоязычных публикациях их называют STT MRAM (spin-torque-transfer MRAM), а еще более новые варианты, где, кроме метода СТП, используют также кратковременное локальное нагревание ячейки памяти во время записи, называют STT+ТА MRAM (STT + Thermally assisted MRAM) или ТА+STT MRAM. Показано, что размер ячейки такой памяти можно уменьшать вплоть до 10 нм, так что площадь ячейки определяется только ключевым транзистором. А время считывания информации в ультрабыстрых вариантах МРОЗУ доведено уже до 300 пс.
Разработаны также варианты быстрой магниторезистивной кэш-памяти. Магниторезистивная память со скоростью считывания и записи порядка 0,5-1 нс стала уже настолько перспективной, что российская компания РОСНАНО создает у себя совместное предприятие для выпуска микросхем такой памяти с французской компанией Crocus Technology.
Если присмотреться к структуре МРОЗУ и к описанной в предыдущей лекции технологии ее изготовления, то легко понять, что она хорошо сочетается с технологией производства КМДП схем. Поэтому ведущие мировые фирмы уже сейчас разрабатывают новые комбинированные микросхемы КМДП+МРОЗУ с объемной интеграцией, в которых "на первом этаже" (под поверхностью и на поверхности кристалла кремния) формируются КМДП логические схемы и процессорные блоки, а над ними, "на втором этаже" того же кристалла, формируется быстрая энергонезависимая магниторезистивная память. Расстояния между логикой и оперативной памятью становятся кратчайшими, что позволяет повысить системное быстродействие. Наличие "встроенной" энергонезависимой памяти значительно расширяет возможности программной настройки и перенастройки логики и процессорных блоков на нужные режимы работы.
Появилась дополнительная возможность реализации новых адаптивных архитектур процессоров на кристалле, их "специализации" под нужды конкретных пользователей.
Трековая память
Рассмотрим процессы спин-транспортного перемагничивания (СТП) в длинной ферромагнитной нанопроволоке с малым поперечным сечением, например, 30х10 нм, в которой сформированы области спонтанной намагниченности (домены) разной ориентации (рис. 2.2.а).
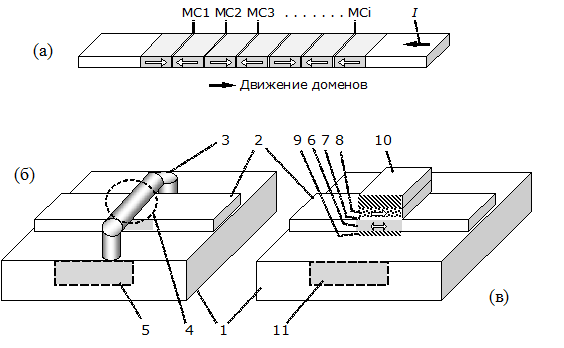
Рис. 2.2. (а) Передвижение магнитных доменов в ферромагнитной нанопроволоке в результате СТП; (б) схема узла записи информации; (в) схема узла считывания информации
Если вдоль такой проволоки пропускать справа налево электрический ток І, то электроны проводимости в нанопроволоке будут двигаться слева направо. К междоменной стенке МС1 подходят в основном электроны с магнитным моментом, направленным вправо. Если сила тока превышает критическое значение СТП, то происходит перемагничивание, и междоменная стенка МС1 смещается вправо. Поскольку движение электронов проводимости слева направо происходит синхронно во всех сечениях ферромагнитной проволоки, то одновременно к междоменным стенкам МС2, МС3, … , МСі тоже подходят электроны. Но они в основном имеют магнитный момент, направленный параллельно направлению намагниченности предыдущего домена. В частности, к МС2 подходят электроны с магнитным моментом, ориентированным влево. В результате СТП доменная стенка МС2 тоже сдвигается вправо. К МС3 в тот же момент подходят в основном электроны с магнитным моментом, направленным вправо. В результате СТП магнитная стенка МС3 сдвигается вправо. Таким образом, под влиянием электрического тока І все магнитные домены, имеющиеся в ферромагнитной нанопроволоке, синхронно перемещаются слева направо. Подчеркнем, что движется лишь состояние намагниченности. Сама нанопроволока и все атомы в ней остаются при этом неподвижными.
Если сквозь ферромагнитную нанопроволоку на рис. 2.2.а пропускать электрический ток І слева направо, то все магнитные домены перемещаются навстречу – справа налево. Таким образом, магнитные домены можно "гонять" вдоль неподвижной ферромагнитной нанопроволоки вперед и назад.
Исследования показали, что критическая плотность тока и скорость движения доменных стенок, а, следовательно, и скорость движения доменов, зависят от материала, из которого сделана нанопроволока, от ее геометрии и от условий на ее границах. Критическая плотность тока составляет 1011-1014 А/м2 (0,1-100 мкА/нм2), а скорость движения доменов 5-500 м/с. В частности, для нанопроволоки из пермаллоя сечением 30х10 нм (с дополнительными слоями) для перемещения доменов требуется электрический ток порядка 30 мкА, а скорость перемещения достигает 100-500 м/с. Конечно же, такие физические возможности сразу же натолкнули на мысль о реализации устройств долговременной памяти, аналогичных накопителям информации на магнитных дисках или забытым накопителям на магнитных лентах, но теперь уже с неподвижным "железом" и с наноразмерами.
На рис. 2.2.б,в показаны возможные узлы записи и считывания информации в/из ферромагнитной нанопроволоки, внутри которой перемещаются магнитные домены. Здесь 1 – полупроводниковая пластина, 2 – ферромагнитная нанопроволока, сформированная на ее поверхности. Для записи информации (рис. 2.2.б) поперек ферромагнитной нанопроволоки проложена проводящая нанопроволока 3 (например, из золота) или углеродная нанотрубка (см. лекции 7 и 8). Если сквозь нее пропустить импульс электрического тока, то вокруг нее возникает магнитное поле, условно изображенное штриховой окружностью 4, достаточно сильное, чтобы намагнитить находящийся под ней участок ферромагнитной нанопроволоки в том или другом направлении (в зависимости от направления тока записи). Внутри полупроводниковой пластины 1 предварительно формируют электронную схему 5, которая в заданный момент вырабатывает и подает в нанопроволоку 3 требуемый импульс тока заданного направления.
Для считывания информации ( рис. 2.2.в) над ферромагнитной нанопроволокой 2 формируют магниторезистивную считывающую головку, которая состоит из сверхтонкого туннельного слоя 7, "фиксированного" ферромагнитного элемента 8 и металлических электродов 9 и 10. В зависимости от направления намагниченности домена 6, электрическое сопротивление "головки" будет меньше или больше. Соответствующие сигналы считывания вырабатывает электронная схема 11, предварительно сформированная внутри полупроводниковой пластины 2.
Основанную на описанных принципах память называют "трековой" памятью или "памятью на беговой дорожке" (англ. Racetrack memory или magnetic racetrack memory, MRM). Она может быть организована по-разному. Разработчики фирмы ІВМ предложили, например, объемную организацию трековой памяти ( рис. 2.3).
Нанопроволоки 1 из ферромагнетика (напр., пермаллоя или сплава Fe-Co) U-образной формы толщиной менее 100 нм и высотой 20-40 мкм устанавливают вертикально на поверхности пластины кремния 2, в которой сформированы электронные схемы управления памятью. Возле дна каждой нанопроволоки 1 сформированы также узлы записи и считывания информации 3. В половине каждой нанопроволоки могут быть записаны 75-280 доменов, в которых хранятся 64-256 битов информации, плюс определенное количество резервных битов для выявления и исправления единичных или двойных сбоев.
С помощью импульсов электрического тока ІПЕР того или другого направления записанные домены могут коллективно перемещаться из левой половины нанопроволоки в правую или наоборот за время порядка 100-200 нс. Электронные схемы управления позволяют адресно обращаться к любой нанопроволоке и за время 150-300 нс считать из нее или записать в нее все 64-256 бит информации.
Такая трековая память является энергонезависимой, долговременной, довольно быстрой. Благодаря вертикальному расположению ферромагнитных нанопроволок обеспечивается плотность записи информации на порядки выше, чем в других видах полупроводниковой памяти. А, следовательно, и удельная себестоимость мегабита информации может быть значительно ниже.
Пока что реализованы исследовательские образцы лишь "плоской" трековой памяти, когда система запоминающих ферромагнитных "дорожек" формируется на поверхности полупроводниковой пластины с электронными схемами управления. В таком варианте тоже можно достичь неплохих результатов. Например, на "дорожке" с поперечным сечением 10х30 нм и периодом расположения доменов 25 нм на 1 мм длины можно хранить 40 кбит информации. Если такие "дорожки" расположены параллельно с периодом 200 нм, то на площади 1 мм2 размещается 5 тыс. "дорожек", в которых будут храниться 200 Мбит информации. Это не намного меньше плотности записи информации на современных жестких магнитных дисках. Зато имеем уже твердотельную память, не требующую высокоточных механических приводов, устойчивую против вибраций и ударов, для обслуживания которой не нужен дополнительный значительный объем.
До промышленного выпуска трековой памяти дело еще не дошло, поскольку не решены пока ряд проблем. Одной из них, например, является то, что электрический ток ІПЕР, требуемый для перемещения доменов, пока еще слишком велик. Из-за выделения джоулевого тепла ферромагнитная нанопроволока довольно сильно нагревается, что резко снижает надежность хранения информации в доменах малого размера.

